| 薄膜厚度测量
|
铌酸锂(LiNbO₃)是一种具有优异电光、声光及非线性光学特性的多功能晶体材料[1],广泛应用于光通信、光调制器和非线性光学器件[2]中。随着产业技术的迭代升级,铌酸锂薄膜的制备工艺日趋精密,其厚度已进入几十至几百纳米的纳米尺度范畴。在此背景下,生产环节需要一种能够实现纳米级精度、快速且无损的薄膜厚度测量手段[3]。
复享光学推出的MetronFilm反射膜厚测量仪[4]为此提供了高效解决方案。该设备基于先进的反射膜厚测量技术,可对透明、半透明薄膜及多种半导体薄膜进行无损检测。不仅能精准测量薄膜厚度,还能同步获得光学常数n&k,且测量重复精度高达0.02 nm。其非接触式测量手段避免了对样品表面的物理损伤,能满足工业生产线对高效、高精度的检测需求。
核心原理
反射膜厚测量基于薄膜多光束干涉原理,当宽光谱白光垂直入射到薄膜表面时,在“空气-薄膜”与“薄膜-基底”两个界面处各自反射,产生的光程差Δ =2nd(n为薄膜折射率,d为膜厚)随波长变化而发生干涉如图1所示:
|
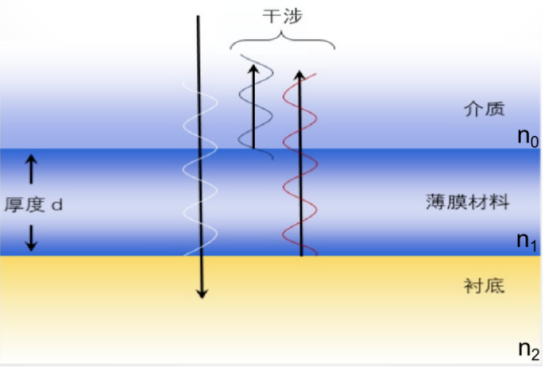
|
图1,多光束干涉原理示意图
|
在实际测量中,为消除光源波动与环境干扰对测量结果的影响,系统首先完成光谱校准:采集参考样品光谱Iref(λ)与暗光谱Idark(λ),再采集待测试样的样品光谱Isam(λ),并通过下式计算样品的反射率:
R(λ) = [Isam(λ) – Idark(λ)] / [Iref(λ) – Idark(λ)]
获得反射率R(λ)后,将其代入菲涅尔反射模型。空气-薄膜界面反射系数r01与薄膜-基底界面反射系数r12的计算公式如下:
r01= (n0–n1)/(n0+n1)
r12= (n1–n2)/(n1+n2)
(其中,n0为空气折射率,n1为薄膜折射率,n2为基底折射率)
最后,通过专用算法对反射光谱进行反演拟合,结合上述光学模型与干涉光程差关系,即可精准求解出薄膜的厚度d,并同步得到其光学常数n&k的色散曲线,实现厚度与光学参数的同步高精度测量。
MetronFilm关键技术参数
为适应不同应用场景的检测需求,复享光学提供MetronFilm与MetronFilm-EX两款反射式膜厚测量仪,其核心参数对比如表1所示:
|

|
表1,MetronFilm与MetronFilm-EX核心参数对比表
|
铌酸锂薄膜实测结果
为验证MetronFilm对纳米级铌酸锂薄膜的测量性能,实验选取在Si/SiO₂基底(SiO₂层厚度4.6μm)上制备的铌酸锂薄膜样品(出厂检测厚度为360nm)进行测试,MetronFilm设备实物图和样品的结构示意图分别如图2a和图2b所示。
|

|
图2,(a) MetronFilm实物图与(b)样品分层结构示意图
|
|
使用MetronFilm在380~1100nm波段采集全谱数据,获得的反射率干涉图谱与n&k色散曲线如图3a和3b所示。
|

|
图3,铌酸锂薄膜反射光谱与n&k色散曲线
|
|
反射率图谱呈现出清晰且规整的周期性干涉条纹,算法拟合曲线与实测数据点高度重合,拟合优度达95%。这充分证明MetronFilm内置光学模型对铌酸锂薄膜材料的适配性。同时,仪器实际测得的样品参数如下表2所示:
|

|
表2,测试样品及实际测量参数表
|
与标称值高度一致,进一步验证了其在纳米级铌酸锂薄膜测量中的高精度与可靠性。
结论
复享光学MetronFilm系列反射膜厚测量仪,凭借其纳米级重复精度、秒级测量速度和无损检测三大核心优势,成功实现了对铌酸锂薄膜的厚度与光学常数n&k的同步精准表征。测试结果验证了该设备对铌酸锂薄膜卓越的测量能力,能够为薄膜铌酸锂光电子器件的研发与规模化生产提供高效、可靠的数据支撑,具有广阔的应用前景。
|
|
|